Thermal Everpoation System 真空蒸着装置
SPE350 ¥5,000,000〜
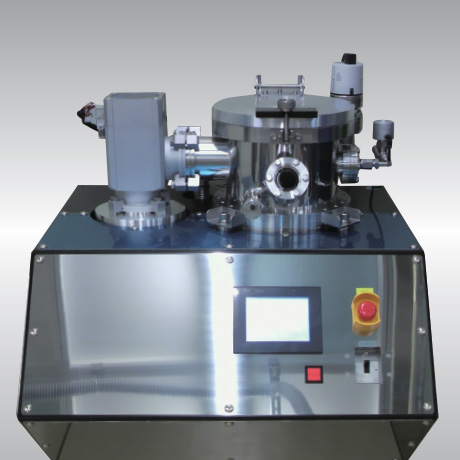
抵抗加熱蒸着方式でボードまたはバスケットに金属や酸化分を加熱して蒸発させ試料表面に堆積させて成膜を行います。
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ200L/S + ロータリーポンプ 90L/S |
| 基板サイズ | 〼100mm |
| 真空計 | フルレンジコールドカソードゲージ |
| 制御 | タッチパネル方式 |
Everpoation or Sputter System 複合型蒸着装置
SPE370 ¥20,000,000〜

4元式抵抗加熱蒸着方式で金属や酸化物を加熱して蒸発させ試料表面に堆積させて成膜を行います。
予備ポート4個有り、スパッタ、EB蒸発元がつけられます。
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ + ロータリーポンプ |
| 真空計 | フルレンジゲージ 基板回転加熱機構 |
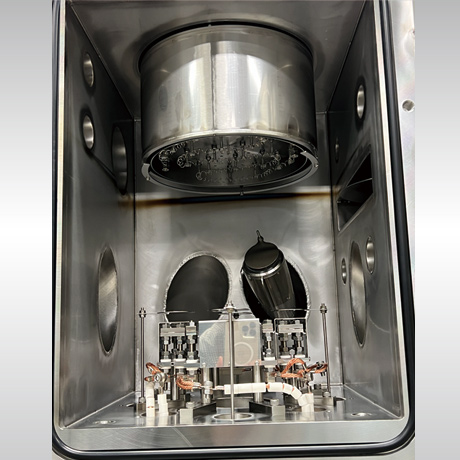
HV-432S フロントハッチ式EB型電子銃装置
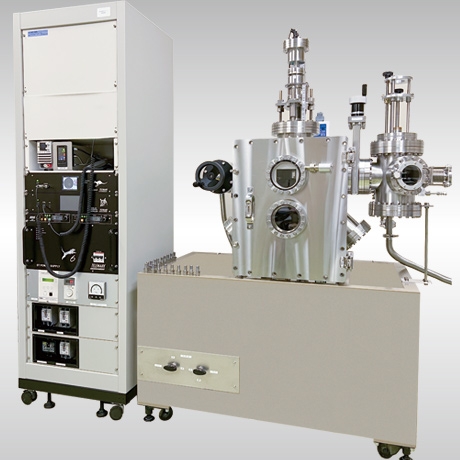
6Kw-4cc 7ポケット回転式EBガンによる多種の試料を装着し成膜が可能です。
フロントハッチ式で試料交換などの作業が効率よく行えます。
またオプションで抵抗加熱式蒸着の取り付けが可能です。
| チャンバー | 角型ハッチ式ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ + ロータリーポンプ |
| 蒸着源 | EB6Kw-4cc |
| 基板回転加熱機構 | MAX300℃ |
| 膜厚計 | STM-2 |
Thermal Everpoation System 真空蒸着装置
SPE367

抵抗加熱蒸着方式でボードまたはバスケットに金属や酸化分を加熱して蒸発させ試料表面に堆積させて成膜を行います。
2元切替式の抵抗加熱蒸着方式
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ300L/S +ダイアフラム |
| 真空計 | フルレンジゲージ |
オプション
- 基板回転機構
Thermal Everpoation System 真空蒸着装置
SPE351 ¥3,000,000〜

抵抗加熱蒸着方式でボードまたはバスケットに金属や酸化分を加熱して蒸発させ試料表面に堆積させて成膜を行います。
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ300L/S +ダイアフラム |
| 真空計 | フルレンジゲージ |
オプション
- 基板回転機構
Thermal Everpoation System 真空蒸着装置
SPE355

抵抗加熱蒸着方式でボードまたはバスケットに金属や酸化分を加熱して蒸発させ試料表面に堆積させて成膜を行います。
2元切替式の抵抗加熱蒸着方式
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ300L/S +ダイアフラム |
| 真空計 | フルレンジゲージ |
オプション
- 基板回転機構
Thermal Everpoation System 小型分析真空装置
SPE352
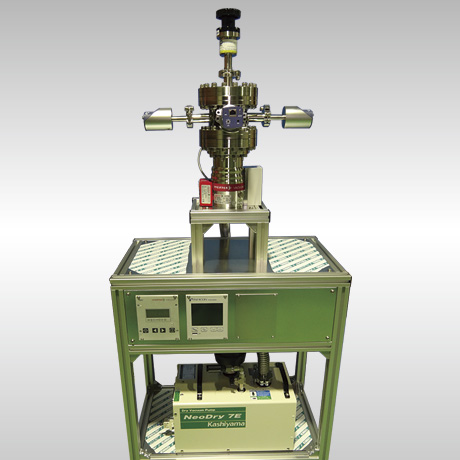
TMPの上部に小型チャンバーを搭載し真空中での分析・評価を行う装置です。
| チャンバー | ステンレス製(SUS304) |
|---|---|
| 排気系 | ターボ分子ポンプ8L/S + ドライポンプ |
| 真空計 | フルレンジコールドカソードゲージ |
Vacuum Baking Oven System 超高真空焼出炉
SPE226
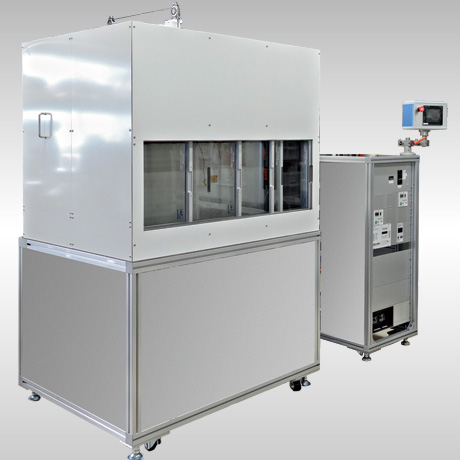
炉内温度700℃MAXで焼出しながら排気できます。
| チャンバー | ステンレス製 |
|---|---|
| 排気系 | ターボ分子ポンプ+ドライポンプ |
| 真空計 | メタルゲージ |
| 炉開閉 | リフト機構 |
Vacuum Analyze System 高真空分析装置
SPE227
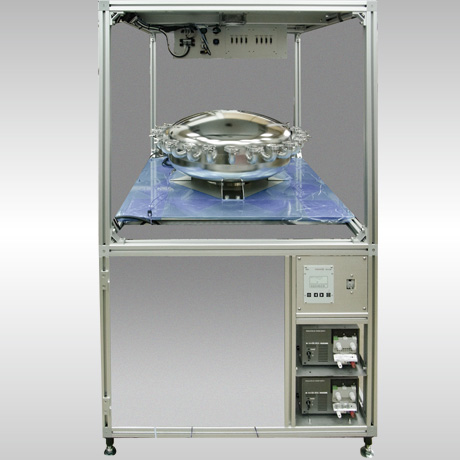
各種真空機器をチャンバーに取付分析する装置です
| チャンバー | ステンレス製 |
|---|---|
| 排気系 | ターボ分子ポンプ+ドライポンプ |
| 制御 | タッチパネル方式 各ポート数をデジタルで抽出チャート表示ができます |
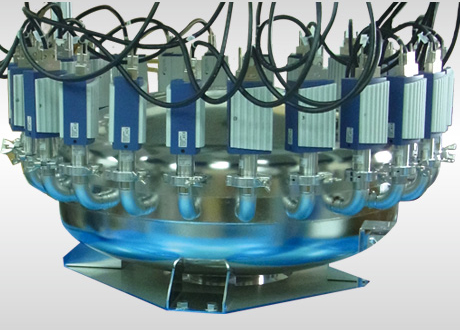
Vacuum System 小型真空排気装置
SPE229 ¥1,000,000〜

シンプル小型真空排気装置
オール手動式で簡単操作
| 排気系 | ターボ分子ポンプ50L/s ロータリーポンプ80L/s フォアラインバルブ オイルミストトラップ付 |
|---|
Vacuum System 真空排気装置
SPE228 ¥1,450,000〜

シンプル小型真空排気装置
オール手動式で簡単操作
| 排気系 | ターボ分子ポンプ350L/s ロータリーポンプ150L/s フォアラインバルブ オイルミストトラップ付 |
|---|

Vaccum System
SPE160
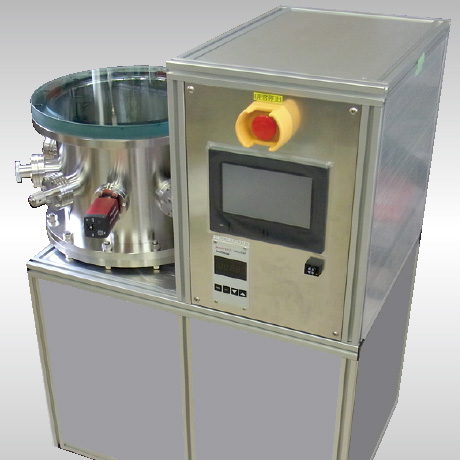
JISチャンバーのトップからチャンバー内の観察ができる。
光学系の分析に利用できる装置です。
トップフランジはガラス仕様
Thermal Everpoation System
フロントハッチ式蒸着装置
SP655 ¥13,000,000〜

試料交換など真空槽の作業が効率よく行えます。
抵抗加熱式、スパッター、EB蒸着その他の研究実験に最適です。
| チャンバー | 角型SUS304(ハッチ式) |
|---|---|
| 排気系 | ターボ分子ポンプ + ロータリーポンプ |
| 蒸着源 | 抵抗加熱、スパッターEB蒸着 |
Vacuum System UHVアニール装置
SP380 ¥4,000,000〜

赤外線発生機構を直上に取付ができる超高真空装置です。
ロードロック室から加熱チャンバーまでトンラスファーロッドにて試料搬送またその他の蒸着装置にて転用できます。
加熱室 |
|
|---|---|
| チャンバー | ステンレス製 |
| 排気系 | ターボ分子ポンプ200L/S + ロータリーポンプ 100L/S |
| 真空計 | フルレンジコールドカソードゲージ |
ロードロック室 |
|
| チャンバー | ステンレス製(SUS304) |
| 排気系 | ターボ分子ポンプ50L/S + ロータリーポンプ50L/S |
| 搬送 | マグネットカップリング式トランスファーロッド |
オプション
- 赤外線発生器 1800°C MAX
- 1インチスパッタ源
- 基板回転加熱機構
Roll-to-Roll System
R2-1000

真空中にてロール to ロール方式により樹脂フィルム上に成膜、添加ガス処理を行う装置です。
| チャンバー | 角型チャンバーSUS304 |
|---|---|
| 排気系 | 空冷式ドライポンプ 1000L/S |
| ロール | ステッピングモーター式(自動制御) |
| 真空計 | キャパシタンスマノメーター |
| 制御 | タッチパネルコントロール |
環境試験装置
En-320
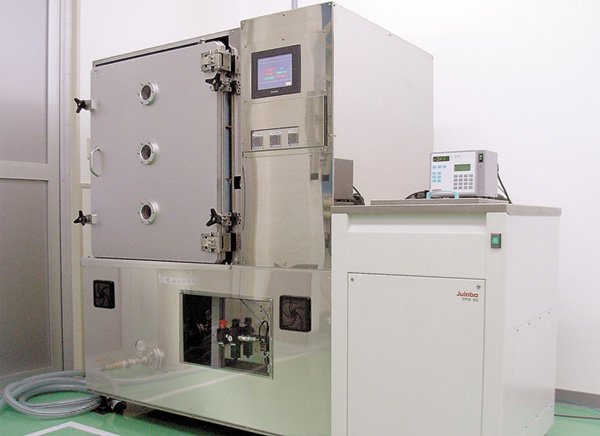
チャンバー内で地球環境上の圧力や温度で試験が行える装置です。チャンバー内に設置された棚は-50℃~200℃まで温度制御されます。
チャンバー内の圧力は1050hPa~200hPaまで制御されます。
Vacuum Drying System 真空減圧乾燥装置
VD150

ガラス基板に塗布したレジストの乾燥をおこなうベーク工程に使用する装置です。
チャンバー内で真空乾燥を行う装置です。
ガラス基板表面へのダメージを抑えた均一な加熱乾燥をすることができます。
| チャンバー | アルミニウム合金 |
|---|---|
| 排気系 | ドライポンプ(到達圧力1.3Pa) |
| 排気時間 | 大気圧〜130Pa(1Torr)まで5sec |
| 基板交換用機構 | チャンバー蓋開閉機構 |
| オプション | メカニカルブースターポンプ |
VD/HP/CP装置
VHC-3040

チャンバー内で真空乾燥を行う装置です。
真空圧力を細かく制御し気泡や風紋を抑制します。
ホットプレートやコールドプレートも合わせた装置で乾燥工程を完了できます。
- スロー排気からメイン排気に切替える2段階排気により風紋や発泡の発生を抑えた乾燥をすることができます
- 常温乾燥することにより、ピン支持部のムラを抑えた乾燥をすることができます
- 減圧乾燥することにより、ベーク行程の時間短縮をすることができます
- 高精度温度分布を実現したホットプレートによるプロキシミティ方式加熱により、基板表面へのダメージを抑えた均一な加熱乾燥をすることができます
- 高精度温度分布を実現したクーリーングプレートにより加熱乾燥後の基板を均一に冷却することができます。
| 基板サイズ | 300×300 300×400 | |
|---|---|---|
| V D 部 | チャンバー材質 | アルミニウム合金 |
| 真空ポンプ | ドライポンプ (到達圧力1.3Pa) | |
| 排気時間 | 大気圧〜130Pa(1Torr)まで5sec | |
| 基板交換用機構 | チャンバー蓋開閉機構 | |
| H P 部 | 加熱プレート材質 | アルミニウム合金 |
| 加熱プレート | カートリッジヒーター挿入によるホットプレート | |
| 加熱方式 | プロキシミティ加熱方式 | |
| 設定温度 | 常温〜250℃ | |
| 温度精度 | 150℃±3℃ | |
基板交換用機構 |
基板リフト機構/基板出入口シャッター機構 | |
| C P 部 | 冷却プレート材質 | アルミニウム合金 |
| 冷却プレート | チラー温調冷却水循環によるクーリングプレート | |
| 冷却方式 | コンタクト冷却方式 | |
| 設定温度 | 22〜25℃ | |
| 温度精度 | 23℃±1℃ | |
基板交換用機構 |
基板リフト機構/基板出入口シャッター機構 | |





 の正式なアフターサービス認定工場です
の正式なアフターサービス認定工場です
 〒206-0801 東京都稲城市大丸422-1
〒206-0801 東京都稲城市大丸422-1